Fig. 7
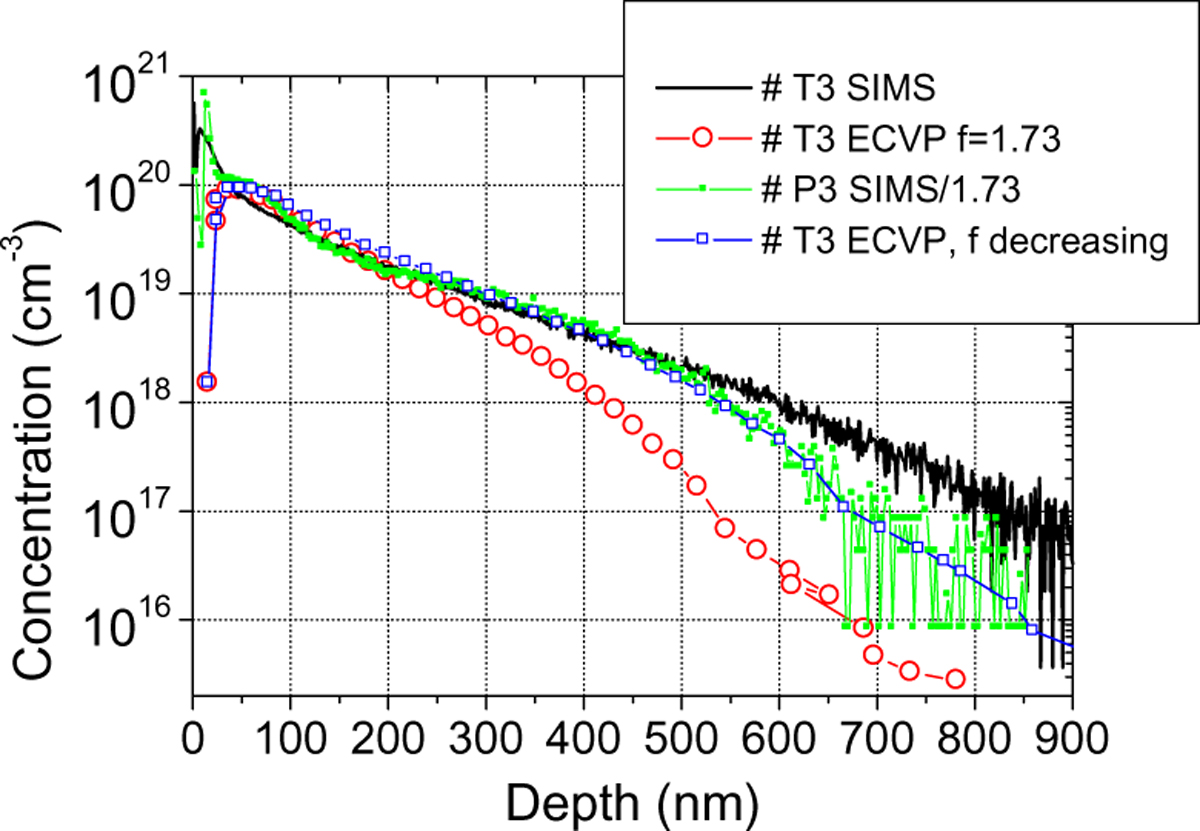
Download original image
Comparison of SIMS and ECVP profiles in the textured wafer T3. SIMS measurement was performed with an incident angle of 36° for the primary ions. Also shown, the SIMS profile on the polished wafer P3 divided by 1.73 and an ECVP curve with a f coefficient decreasing along the profile.
Current usage metrics show cumulative count of Article Views (full-text article views including HTML views, PDF and ePub downloads, according to the available data) and Abstracts Views on Vision4Press platform.
Data correspond to usage on the plateform after 2015. The current usage metrics is available 48-96 hours after online publication and is updated daily on week days.
Initial download of the metrics may take a while.


